影响MOS器件及其集成电路可靠性的因素很多,有设计方面的,如材料、器件和工艺等的选取;
有工艺方面的,如物理、化学等工艺的不稳定性;也有使用方面的,如电、热、机械等的应力和水汽等的侵入等。
从器件和工艺方面来考虑,影响MOS集成电路可靠性的主要因素有三个:一是栅极氧化层性能退化;二是热电子效应;三是电极布线的退化。
MOSFET的栅极二氧化硅薄膜是决定器件性能的关键性材料。因为二氧化硅薄膜具有良好的绝缘性,同时它与Si表面接触的表面态密度又很低,所以最常用作为栅绝缘层。
栅氧化层一般是采用热氧化来制备的,良好氧化层的漏电流基本上为0,并且具有较高的击穿电场强度(击穿电场强度约为10MV/cm)。
但是,实际上发现,在器件和电路工作时,有时会发生由于栅氧化层的漏电、并导致击穿而引起的失效;产生这种后果的根本原因就是氧化层在电压作用下性能发生了退化。
一、栅氧化层性能退化的表现:击穿
在栅极电压作用下,栅氧化层发生性能退化的主要表现就是击穿。
这里存在两种类型的击穿:一是瞬时击穿(TZDB,Tims Zero Dielectic Breakdown),即是加上电压后就马上发生的击穿——短路;
二是经时击穿(TDDB,Tims Dependent Dielectic Breakdown),即是加上电压后需要经过一段时间之后才发生的击穿。
MOSFET和MOS-IC的早期失效往往就包括有栅氧化层的TZDB现象。
TDDB的产生与栅氧化层中的电场(栅电压)有关。实验表明,按照引起击穿电场的大小,可以把TDDB区分为三种不同的模式:
①模式A--在较低电场(1MV/cm)时就产生的击穿;②模式B--在较高电场(数MV/cm)时产生的击穿;③模式C--在很高电场(>8MV/cm)时才可能产生的击穿。
TDDB的模式A往往是由于氧化层中存在针孔等缺陷的缘故,具有这种模式的早期击穿的芯片,一般都可通过出厂前的筛选而淘汰掉,故模式A击穿将直接影响到芯片的成品率。
由于氧化层中的针孔等缺陷主要是来自于材料和环境的污染、微粒之类的杂质,所以提高材料和工艺的纯净度对于降低出现模式A的几率、增高成品率具有重要的意义。
TDDB的模式B往往是由于氧化层中存在微量的Na、K等碱金属和Fe、Ni等重金属杂质的缘故,这些杂质离子在较高电场作用下会发生移动,并且起着陷阱能级的作用。
因此,为了提高模式B的击穿,也必须严格保证材料和工艺的纯净度,此外还必须注意晶体表面缺陷吸附重金属杂质所产生的不良影响(则需要关注衬底的结晶控制技术)。
TDDB的模式C击穿电压很高,接近二氧化硅的固有击穿特性,这是由于氧化层中不存在杂质和缺陷的缘故。
二、MOSFET栅氧化层退化的寿命评估
对于带有经时击穿模式B的不良芯片,需要经过较长时间的试验才能检测出来,因此必须事先确立器件寿命的检测和评估方法。
为了保证集成电路能够正常工作若干年(一般要求10年以上),就需要在出厂前预测出器件的寿命——寿命评估;这可以通过TDDB试验预测出栅氧化层的寿命来确定器件的寿命。
具体的办法就是采用所谓加速寿命试验,即把许多器件置于强电场(高于7MV/cm)、温度为100 0C左右的条件下,观测器件的经时失效率;
一般,栅氧化层的TDDB呈现出两个区域:较快击穿的早期失效区和需要经过很长时间才击穿的磨损失效区(二氧化硅的固有击穿区)。为了不让器件在出厂后就产生问题,则必须尽量控制器件的早期失效。
对于较厚栅氧化层的器件,发现早期击穿的失效率较高,这说明较厚的二氧化硅中含有较多的缺陷。
三、栅氧化层性能退化的机理
栅氧化层出现性能退化的主要原因是强电场使得栅氧化层产生了漏电、并从而导致的击穿。
1、在强电场作用下,栅氧化层产生漏电往往是一种常见的现象。
实际上,当氧化层中的电场强度大于6MV/cm时,即使是非常优质的氧化层,也将会产生由于量子效应所引起的所谓F-N(Flowler-Nordheim)型隧道电流。
随着器件尺寸的缩小,氧化层厚度也相应地越来越薄(对于LSI而言,一般总是选取栅氧化层厚度为沟道长度的1/50左右),则氧化层的这种F-N型隧道电流也将越来越显著。
例如,对于厚度为10nm的栅氧化层,在电源电压为5V时,氧化层中的电场就已经大于5MV/cm,所以往往就必须考虑F-N型隧道电流以及所引起的击穿。
2、栅氧化层的不断漏电,就会导致氧化层击穿,这是由于漏电会使得在氧化层中积蓄起很多电荷(正电荷或者负电荷)的缘故。
因为栅氧化层中往往存在许多陷阱(电子陷阱、空穴陷阱或者中性陷阱),当氧化层有隧道电流通过时,则这些陷阱就会俘获载流子、积蓄起正电荷或者负电荷,并使得氧化层的局部电场增强;
由于电荷积蓄而导致局部电场增强时的能带图见图2和图3,其中图1是没有电荷积蓄时的能带图。
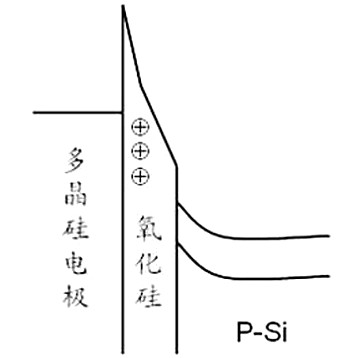
〈烜芯微/XXW〉专业制造二极管,三极管,MOS管,桥堆等,20年,工厂直销省20%,上万家电路电器生产企业选用,专业的工程师帮您稳定好每一批产品,如果您有遇到什么需要帮助解决的,可以直接联系下方的联系号码或加QQ/微信,由我们的销售经理给您精准的报价以及产品介绍


